ald는 cvd와 비슷하게 고온 저압의 형태로,
원자층 두께로 박막을 매우 얇고 균일하게 증착함
차이점은 cvd는 반응가스를 동시에 공급vs ald는 펄스형태로 공급이 차이점
->하나의 공정사이클=하나의 원자층 (시간오래걸림)


1. 장비의 구성

-반응가스의 소스역할하는 전구체 ex. 하프늄 소스
(ald진행에 필요한 precursor를 보관하는 canister)
-웨이퍼를 로드하게 되는 로드락챔버 & 공정이 진행되는 process챔버



: Ar가스의 사용_ 불활성 가스를 사용 ex.ar gas 하여 반응가스를 이동시키는 데에 사용한다(?),
라인을 purge(라인을 클리닝)해주는 데에 사용된다.
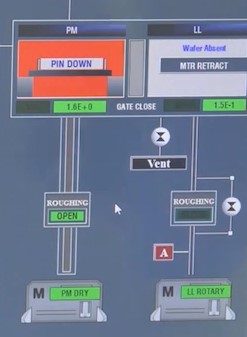
: 로드락 챔버에 로딩된 웨이퍼 -> process 챔버로 이동하는 과정
(vent이후 로드락 챔버에 웨이퍼가 로딩되고, 로드락 내부 진공을 뽑고나서 게이트가 열려 웨이퍼를
로드락 암으로 공정이 진행되는 process 챔버 내로 이동이 된다.)
2. 하프늄 옥사이드 박막을 쌓는 ald 과정 진행
1. 하프늄 옥사이드를 쌓는 recipe 를 확인
(5가지 단계)
2. 웨이퍼를 로드락 챔버에 집어넣는 wafer loading과정
3. 공정 레시피를 start시킨다.
full automation run!
-로드락에서 어느정도의
진공도가 확보 될때까지 진공pumping을 진행한다.
-로드락챔버와 process챔버 사이의 게이트 밸브가 열린다.
웨이퍼를 로드암으로 이동시킨다.
-ald공정에 의해서 박막을 증착하는 단계거침


: 그러므로 게이트나 capacitor와 같이 critical한 공정에 주로 사용되고 있다. (특성이 주요한 소자에 사용됨)
'연수사항' 카테고리의 다른 글
| 세미묵_소자데이터 측정을 통해 특성알기 (mos의 c-v측정, tft의 id-vd, id-vg측정) (0) | 2022.09.12 |
|---|---|
| 세미묵_박막두께측정방법 (광학방법, 물리적방법 이용) (0) | 2022.09.12 |
| 세미묵_etching (icp-rie 장비를 이용해 sio2박막 식각) (0) | 2022.09.12 |
| 세미묵_Annealing=열처리 (0) | 2022.09.11 |
| 세미묵_thinfilm deposition (PVD=dc sputter/rf sputter) (0) | 2022.09.08 |



